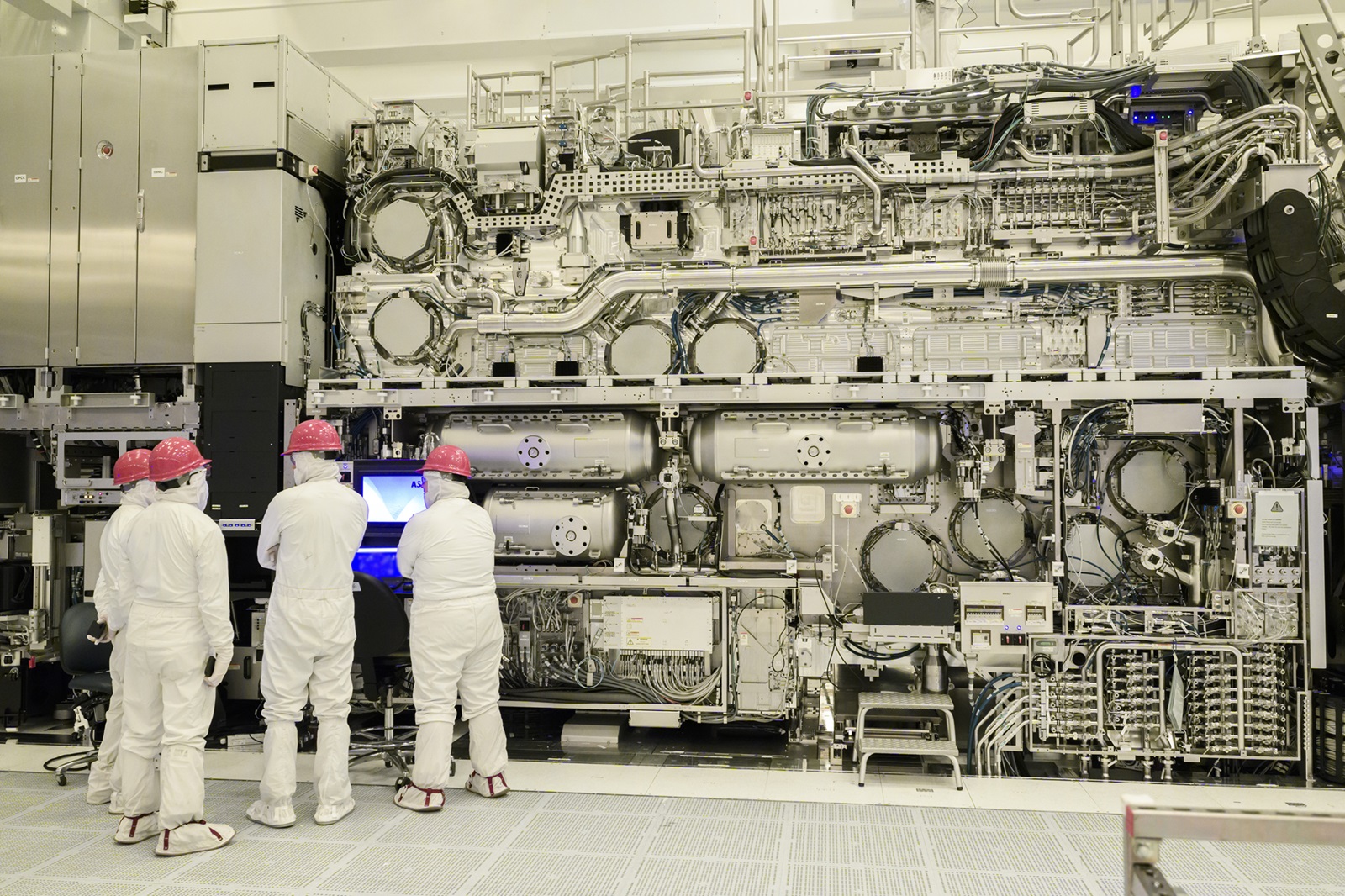
英特爾宣布,美國俄勒岡州希爾斯伯勒的研發基地中,已完成業界首台ASML供應的商用高數值孔徑極紫外光微影設備(High NA EUV)組裝,型號為TWINSCAN EXE:5000。
該機台正在進行多項校準步驟,預計2027年啟用,率先用於Intel 14A流程,協助英特爾推廣未來流程藍圖。 此設備將投影印刷成像到晶圓的光學設計進行改造,明顯提升下世代處理器的圖像解析度和尺寸縮放。
英特爾計劃於2025年Intel 18A的產品驗證,以及未來Intel 14A的量產階段,都會採用0.33和0.55數值孔徑的EUV微影設備。
《高數值孔徑極紫外光微影設備High NA EUV小科普》
高數值孔徑極紫外光High NA EUV技術使用人工的13.5納米光波長。 此一光波長是利用強大的雷射光束,照射加熱至將近22萬攝氏度的錫滴上而產生,此溫度高出太陽表面平均溫度40倍。 光束從含電路圖案模板的光罩反射,再穿過高精度鏡組打造的先進光學系統。
NA(Numerical Aperture)數值孔徑為衡量光收集和聚焦能力的重要指標,用在光學系統上,決定了光刻的實際圖案解析度和縮小晶體管尺寸,以及能夠做到的製程節點。 然而,要進一步製造尺寸較小的晶體管,仍需要全新的晶體管結構和相關製程步驟。
ASML目前的EUV曝光機NA只有0.33,對應的解析度為13nm,可以生產金屬間距在38~33nm之間的晶片。 往下發展到金屬間距縮小到30nm以下,也就是對應的製程節點在5nm以下,解析度就不夠了。 或是需要用多重曝光(pattern shaping)技術來輔助,會導致成本增加且影響良率。
ASML新一代的高數值孔徑EUV設備EXE:5000可以做到0.55 NA,解析度縮小到8nm。 相較於0.33數值孔徑的EUV微影設備,高數值孔徑EUV微影設備(或0.55數值孔徑的EUV微影設備)可為類似的晶片尺寸提供更高的影像對比度,可減少每次曝光所需 的進光量,並縮短每層列印時間,從而提高晶圓廠的產能。
採用第一台高數值孔徑EUV的英特爾指出,當High NA EUV微影設備與其他在英特爾晶圓代工服務的領先製程技術相結合時,印刷尺寸預計將比現有EUV機台縮小1.7倍。 由於2D尺寸縮小,密度將提高2.9倍,英特爾將持續引領半導體產業發展更小、更密集的圖案化(pattterning)技術,進一步延伸摩爾定律。
《台積電為什麼不急著導入高數值孔徑EUV? 》
過去半導體進入EUV時代,全球也是三星第一家先使用EUV設備的Foundry廠,台積電第一代7nm製程仍是用多重曝光,第二代7nm製程才改用EUV技術。
晶體管架構從FinFET(鰭式場效晶體管)轉換到GAA(環繞閘極場效晶體管)架構,競爭對手三星、英特爾都在3nm製程搶著採用GAA晶體管,台積電的3nm電晶體架構仍是沿用FinFET,直到2nm製程才會改採 GAA晶體管架構,預計2025年量產。
從EUV技術導入、採用GAA電晶體,一直到使用高數值孔徑EUV技術等歷程,可以看出台積電的作風偏向謹慎保守,不會衝第一個採用新技術。
台積電曾回應何時使用高數值孔徑EUV設備時表示,技術本身的價值只有在為客戶服務時,方能彰顯出來。 每當新的工具或設備,台積電都會先研究,看看工具的成熟度和成本,再進一步評估如何實現。
圖說:ASML的TWINSCAN EXE:5000系統的總重量超過150噸,將先分裝於250多個貨櫃中,並集中裝入43個集裝箱,集裝箱由多架貨機運送至西雅圖,再利用20輛卡車 運輸到俄勒岡州。 一台售價將近4億美元! ! !
相關新聞:
台積電:除了AI,沒一個能打的!!
ASML首季財報靠中國獨撐,淨系統收入貢獻高達49%